
作者:张国斌
7月27日——以工艺进展稳健著称的英特尔曾被业界戏称为“牙膏厂”,形容其在每次工艺更新迭代时如挤牙膏一样,但是,自从新一任CEO帕特·基辛格上任以后,英特尔风格有很大变化,他提出了英特尔要走IDM 2.0 战略,并要提供英特尔代工服务(IFS),由于以往英特尔曾两次提出要提供代工服务但最后都铩羽而归,所以对于此次提出的代工服务业界仍是充满疑虑,不过,从今天的发布看,这个疑虑可以打消了。

在7月27日“英特尔加速创新:制程工艺和封装技术线上发布会”上,英特尔CEO帕特·基辛格发表了重要演讲,一口气发布了未来5年及更远的工艺演进路线。

此外,英特尔还公布了其近十多年来首个全新晶体管架构 RibbonFET 和业界首个全新的背面电能传输网络PowerVia,同时透露英特尔将领先台积电率先获得业界第一台High-NA EUV光刻机,凭借它英特尔将迅速采用下一代极紫外光刻(EUV)技术的计划,即高数值孔径(High-NA)EUV。
这些发布向业界表明了其开展代工服务的决心,同时基辛格也透露AWS已经采用了英特尔的代工服务,而高通将获得英特尔的EUV工艺代工服务。
重新命名工艺节点
在今天的发布中,一个最大的亮点是,英特尔不再以纳米工艺来命名工艺节点,从10nm以后,英特尔的工艺节点名称将是Intel 7、Intel 4、Intel 3和Intel 20A,而且每个节点升级有精确的参数性能,说明英特尔在这方面已经投入了很大的研究,未来不会再挤牙膏了。几个节点的性能如下:
1、基于 FinFET 晶体管优化,Intel 7与 Intel 10nm SuperFin 相比,每瓦性能将提升约10%-15%。2021年即将推出的Alder Lake客户端产品将会采用Intel 7 工艺,之后是面向数据中心的 Sapphire Rapids预计将于 2022 年第一季度投产。
2、Intel 4完全采用 EUV 光刻技术,可使用超短波长的光,刻印极微小的图样。凭借每瓦性能约 20% 的提升以及芯片面积的改进,Intel 4 将在 2022 年下半年投产,并于 2023 年出货,这些产品包括面向客户端的 Meteor Lake 和面向数据中心的 Granite Rapids。
3、Intel 3凭借FinFET 的进一步优化和在更多工序中增加对EUV使用,较之Intel 4将在每瓦性能上实现约18%的提升,在芯片面积上也会有额外改进。Intel 3将于2023年下半年开始用于相关产品生产。
4、Intel 20A将凭借RibbonFET和PowerVia两大突破性技术开启埃米时代。RibbonFET 是英特尔对Gate All Around晶体管的实现,该技术加快了晶体管开关速度,同时实现与多鳍结构相同的驱动电流,但占用的空间更小。PowerVia 是英特尔独有的、业界首个背面电能传输网络,通过消除晶圆正面供电布线需求来优化信号传输。Intel 20A 预计将在 2024 年推出。英特尔也很高兴能在Intel 20A 制程工艺技术上,与高通公司进行合作。
5、2025 年及更远的未来:从Intel 20A更进一步的Intel 18A节点也已在研发中,将于2025年初推出,它将对RibbonFET进行改进,在晶体管性能上实现又一次重大飞跃,据基辛格透露英特尔还致力于定义、构建和部署下一代High-NA EUV,有望率先获得业界第一台High-NA EUV光刻机。英特尔正与 ASML 密切合作,确保这一行业突破性技术取得成功,超越当前一代 EUV。

英特尔研究院副总裁、英特尔中国研究院院长宋继强博士在接受采访时指出英特尔以前是隔年更新工艺,这次直接以“年”为单位的工艺更新,节奏很快。“我们为什么要对节点开始重新命名?其实对外界做了很多咨询,因为从20年前,从Donald law开始失效,从纯粹靠晶体管微缩去提高芯片晶体管密度的技术失效之后就采用了其他各种各样的技术来提高我们芯片上的晶体管密度,有3D的,有应变硅等等。它不再是通过简单的根据晶体管当中的栅极长度(gate length)去评估我的芯片生产工艺是几纳米。”他解释说,“2011年之后,市场上说的“几纳米”工艺变成了一个市场营销代名词。所以对于客户来讲,你说他现在接受了这样一个命名,是不是说这个命名未来就可以持续下去了?你也可以想象,如果说大家都把2纳米、3纳米用完了之后再往后怎么办?大家都说我是1纳米吗?你真的到了1纳米吗?按照这个速度很快就要前进到1纳米了该怎么办?英特尔和很多外界包括学术界、产业界的客户做了一些调研,大家希望重新恢复到正确的命名,包括怎么样去理清楚这些命名到底和制造工艺之间有没有直接的关系。”
他表示现在英特尔重新梳理了一下之后,觉得至少仍然可以用数字,用数字的递减代表工艺还在不断的向前发展,但是英特尔已经不再强调这个数字和纳米之间的关系。“因为本身行业内的人知道,它没有关系,或者说和栅极长度之间的关系。这是需要一个概念转换的过程的。”他指出,“同时我们的命名也为未来10年发展留下了空间,我们到Intel 3之后,没有到2到1,而是到了Intel 20。因为到了Intel 20之后可以预见到,到1中间还会有一些未来可能会发生的创新。其实我们现在并不清楚,你要给未来留下空间,所以到20的时候,我们叫20A,是给未来继续留下了空间。所以现在这个命名方案,对于英特尔,目标是一直要去推进半导体制造工业的,所以未来10年我们知道怎么样通过半导体技术去推进它的PPA(性能、功耗、面积),那就需要留下足够的空间。因此基于这些逻辑重新梳理一下这些,同时我们也趁着这个时候把封装技术给联系起来。因为以前太过强调我通过几纳米去缩小晶体管就好了,3纳米的工艺也没有真的把晶体管收缩到3纳米。”
封装技术继续创新
在后摩尔时代,异构集成成为芯片的主要发展方向,在这个领域,英特尔经过深入研发,推出了几个针对封装的总线技术(详见我2019年的一篇文章《英特尔发现一个大趋势,其他厂商会跟进吗?》),在今天的发布中,英特尔也更新了封装技术。

1.EMIB作为首个 2.5D 嵌入式桥接解决方案将继续引领行业,英特尔自2017年以来一直在出货EMIB产品。Sapphire Rapids 将成为采用EMIB(嵌入式多芯片互连桥接)批量出货的首个英特尔®至强®数据中心产品。它也将是业界首个提供几乎与单片设计相同性能的,但整合了两个光罩尺寸的器件。继Sapphire Rapids之后,下一代 EMIB的凸点间距将从 55微米缩短至 45微米。

2.Foveros利用晶圆级封装能力,提供史上首个 3D 堆叠解决方案。Meteor Lake是在客户端产品中实现Foveros技术的第二代部署。该产品具有 36微米的凸点间距,不同晶片可基于多个制程节点,热设计功率范围为 5-125W。

3.Foveros Omni开创了下一代Foveros技术,通过高性能3D堆叠技术为裸片到裸片的互连和模块化设计提供了无限制的灵活性。Foveros Omni允许裸片分解,将基于不同晶圆制程节点的多个顶片与多个基片混合搭配,预计将于2023年用到量产的产品中。
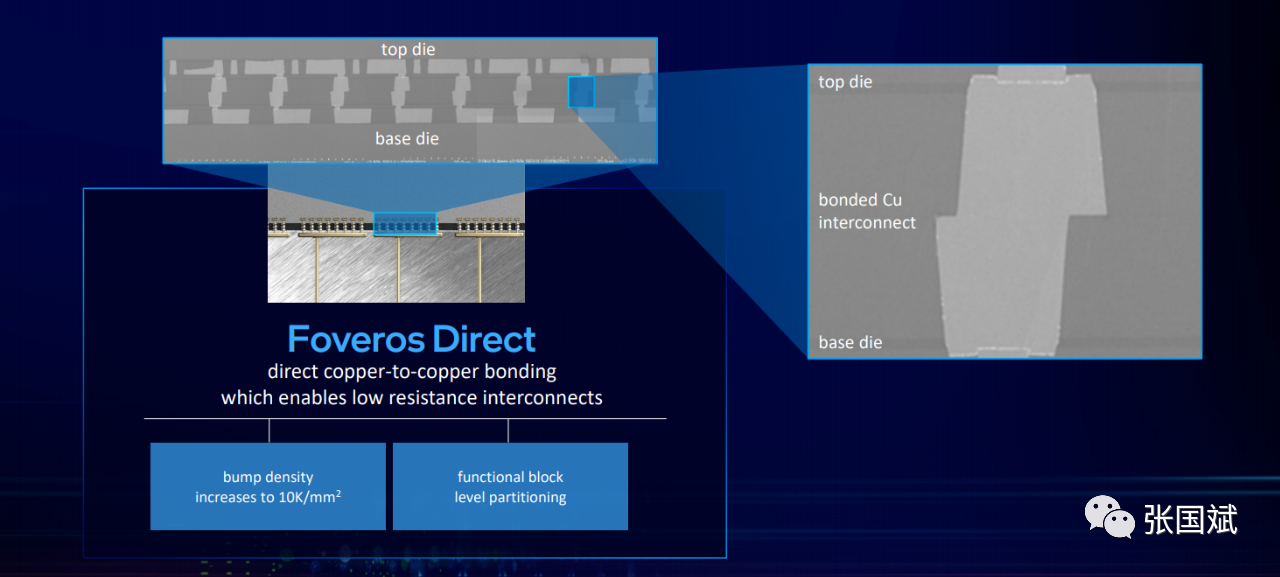
4.Foveros Direct实现了向直接铜对铜键合的转变,它可以实现低电阻互连,并使得从晶圆制成到封装开始,两者之间的界限不再那么截然。Foveros Direct 实现了10微米以下的凸点间距,使3D堆叠的互连密度提高了一个数量级,为功能性裸片分区提出了新的概念,这在以前是无法实现的。Foveros Direct 是对 Foveros Omni 的补充,预计也将于 2023年用到量产的产品中。
Foveros Direct目前提供10微米的凸点间距,甚至比提供25微米微凸点的Foveros Omni也有很大的改进。对于Foveros Omni来说,在0.15 pJ/bit的情况下,这相当于约1600根线/mm²。对于Foveros Direct,这一数字增加到>10,000线/mm²。
宋继强表示异构集成是芯片未来发展的一条路径,封装工艺会和原来的半导体本身制造工艺相辅相成,
“EMIB大家已经听说过很多次了,我们已经在产品当中用了几代了。目前来讲,我们这一次有一个Sapphire Rapids,是业界首次把两个光罩尺寸器件通过EMIB连接在一起,最终它的性能和单片处理器是一样的。这样我们就更有信心通过先进封装能力做更大的芯片方案。”他解释说,“这次重点是讲了Foveros,Foveros是3D的封装能力,它在凸点的间距上完全优于EMIB,EMIB是从55降到45再降到40,差不多已经达到了EMIB可以做到的间距下限了。Foveros是直接从三十几um开始,它可以去做3D堆叠解决方案。 在Foveros方面我们继续推新的技术,一个是以前我们介绍过的ODI(Omni-Directional Interconnect),现在重新命名为Foveros Omni,这个实际上主要就是我们允许它在封装的时候能够把不同制程的多个顶片和基片,上下混合搭配去封装,它的连接方向上,包括连接层次上有上下层可以多对多互相连接,非常的灵活。EMIB或者是原来的Foveros有的时候还需要通过TSA过孔。Foveros Omni在边上有铜柱,铜柱可以让它去跨越上下层之间有些可能并不完全对齐,或者原来可能并不是完全align好的的芯片,也可以想办法把它封装在一起,这就可以有很大的灵活度,能够允许我们把这个技术应用在更多的厂商或者是合作伙伴一起提供的芯片当中。”

他表示这次提的Foveros Diret就是之前讲到的Hybrid Bonding技术,它能够把芯片直接连接起来并大幅度缩小凸点之间的间距。原来大家讲到的是几十um,EMIB是40um以上,Foveros是三十几um,二十多就差不多了。现在如果是用Foveros Diret可以降到10微米以下的间距。这样的话,它的互连的密度就提高了.
“因为在这个技术里完全不需要使用焊料。原来的技术还需要使用焊料,要先加热片,然后把焊料粘上去,再把两片粘在一起,这个本身要留给焊料余地,否则焊料和焊料直接接触就废掉了。而Hybrid Bonding完全不需要焊料,上下都是铜,铜之间处理的非常好,所以它可以在常温下先让它键合起来,然后再去加热让它们融合起来,这样就会非常稳固,不需要再给焊料留余地空间,这样可以把整个凸点之间的间距控制的更小。”他解释说,“这些把它混合起来之后,你可以看到我们可以把I/O密度做到很大,甚至可以做到以前做芯片silicon-level。”
英特尔搞代工服务谁最受伤?
从这次英特尔重新命名工艺以及在封装方面继续创新来看,英特尔是铁定要开展代工业务了,目前高通已经表示要采用英特尔的服务,包括应用材料、ASML、IMEC、IBM在内的多家公司对英特尔的这个服务前景看好,IBM研究院混合云副总裁Mukesh Khare表示:“IBM和英特尔在尖端的半导体逻辑和封装方面有着悠久的创新史。从人工智能到混合云再到下一代系统,两家知名公司的合作将继续推动技术的前沿进步。我们很高兴能与英特尔在关键研究方面进行合作,开发基础性技术,支持整个电子产业未来数年的发展。”
这样看来,未来台积电的代工生意将面临被英特尔部分截胡的危险了。
注:本文为原创文章,未经作者授权严禁转载或部分摘录切割使用,否则我们将保留侵权追诉的权利!
