
贺利氏电子-宋建波
摘要:
在半导体封装领域,键合线作为连接芯片与外部框架的"关键桥梁",其性能直接影响整个电子系统的可靠性与寿命。随着汽车电子、工业控制和新能源领域的快速发展,对键合材料的要求也日益严格。贺利氏电子凭借其深厚的技术积累,推出了一系列创新的铝线和粗铜线解决方案,为功率电子封装提供了更多优化选择。
一、铝线键合技术的创新与发展
贺利氏在铝线键合材料领域拥有完整的产品系列,针对不同应用场景提供了专业化的解决方案。

图1.贺利氏铝线产品分类
二、核心产品深度解析:Al Prime
以应用广泛的 Al Prime 为例,该产品采用高纯度铝基材,通过添加并均匀分布镍(Ni)等微量元素,显著提升了材料的耐水汽腐蚀性能。Al Prime能满足汽车和电力电子领域对键合连接可靠性日益提高的需求。
2.1产品核心优势
卓越的抵抗水汽腐蚀能力
可以做软态(S)和硬态(M)两种状态
具备宽泛的键合工艺窗口
可以被加工成铝带产品
2.2 线材显微组织结构
通过优化的热处理工艺,Al Prime形成了成分均匀、形态一致的再结晶晶粒组织,彻底消除了冷加工后的纤维状结构。这种均匀的晶粒结构使线材更具柔韧性,从而显著提高了结合力与抗应力腐蚀能力。
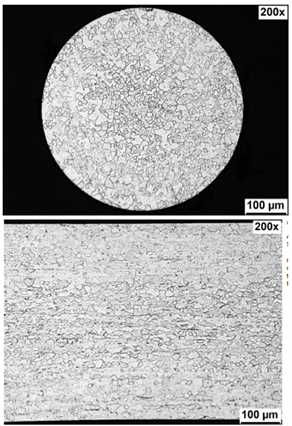
图2. Al Prime(20mil)晶粒结构
三、键合验证与可靠性表现
3.1 客户应用案例
型号 | AL-Prime Soft |
线径 | 20mil |
破断力 | 850-1150g |
延伸率 | >10% |
键合机 | K&S OE7200 |
封装类型 | TO, (Bare Cu LF) |
键合关键质量特性(CTQ)表现如下:




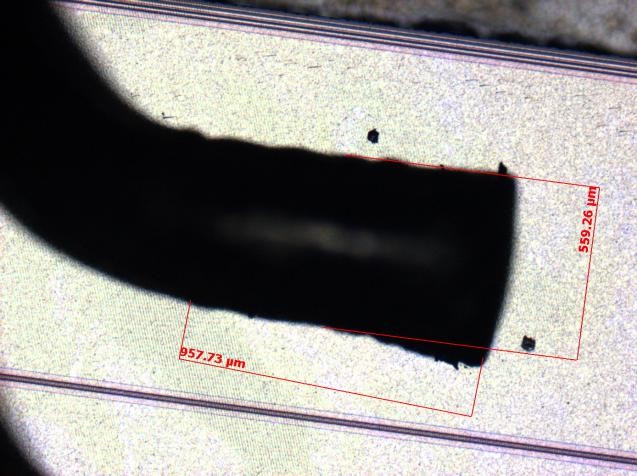
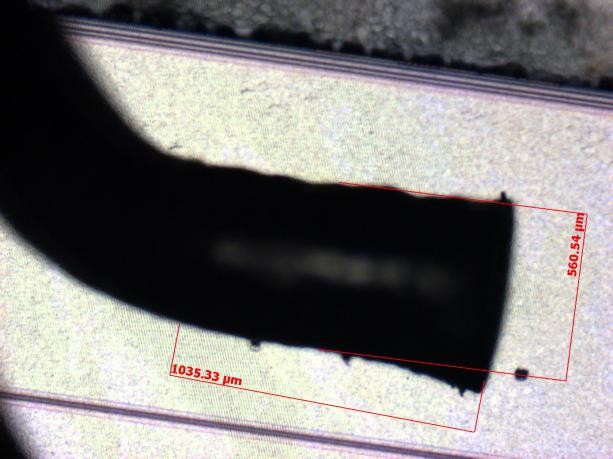
图3.焊点图片
关键的键合结果能完全满足客户标准。
3.2可靠性测试分析
3.2.1抗水汽腐蚀测试
Pressure Cooker Test(高温蒸煮)
(PCT :121°C, 100% humidity, 2 bar)
测试结果显示20mil
Al Prime铝线在经过PCT250小时后,抗拉强度没有出现明显衰减的迹象,说明该型号铝线具有出色的抗水汽腐蚀的能力。
在铝凝固阶段,微量镍原子会向晶界偏聚。它们吸附在阴极活性位点上,通过提高析氢过电位抑制关键的阴极反应,直接降低腐蚀电流并减缓铝的阳极溶解。同时,镍的偏聚还通过调节局部电化学环境、降低微区电位差,进一步减弱腐蚀驱动力。

图4.高温蒸煮测试结果
3.2.2抗热疲劳测试
Power Cycling Test (功率循环测试)
以下数据来自贺利氏与赛米控的联合实验,12mil Al Prime键合于二极管芯片,从以下测试条件及结果可以看出,随着结温(ΔTj)升高,功率循环寿命显著下降。
焊点脱落是主要的失效模式,由于芯片与线材之间的热膨胀系数的差异,以及在不断的温冲影响下,结合面抵抗热疲劳的能力退化,导致裂纹产生。
优化方向: 为提升抗热疲劳性能,可考虑采用CuCorAl或Cu键合材料。
ΔTj | Tmin | Tmax | ton | Cycle | |
a) | 70k | 80℃ | 150℃ | 1.0s | 380000 |
b) | 110k | 40℃ | 150℃ | 1.6s | 60000 |
c) | 135k | 40℃ | 175℃ | 2.0s | 21000 |
图5. 功率循环测试条件及结果
四、结论与展望
贺利氏电子的铝线解决方案通过持续的合金优化与工艺创新,在传统功率封装领域中持续提供高可靠性价值。Al Prime等产品凭借其优异的抗腐蚀性和稳定的键合性能,已成为严苛环境应用的理想选择。
与此同时,为满足更高性能需求,贺利氏已布局粗铜线键合技术,通过材料与工艺的双重突破,为下一代功率电子封装提供更强动力。敬请期待下期粗铜线解决方案的详细介绍。
