
作者:电子创新网张国斌
由于HBM(高带宽存储器)能够有效解决传统内存技术在带宽、功耗、空间和集成度等方面的瓶颈满足现代高性能计算和人工智能应用对内存的严苛要求,所以,随着人工智能和高性能计算的飞速发展,HBM市场迎来发展大机遇--预计到2025年市场规模将达到350亿美元以上,并有望在2033年达到1300亿美元,而2023年全球HBM市场规仅为为43.56亿美元!仅仅两年就增长近10倍!
HBM的高速发展给应用到的设备带来发展机遇,这些设备包括深孔刻蚀设备、气相沉积设备、铜填充设备、减薄抛光设备、Bump(凸点)工艺设备、热压键合设备(TCB)、混合键合设备以及各种塑封、检测设备等,。
这其中热压键合设备(TCB)、混合键合设是实现HBM封装的关键设备,虽然目前HBM的主流封装技术仍然是基于TC Bonding(热压键合)的方案,但混合键合(Hybrid Bonding)技术正在逐渐兴起,并有望在未来成为主流。
在SEMICON China2025开幕前夕,全球半导体封装与电子装配解决方案领导者库力索法(Kulicke & Soffa)就发布了两项突破性技术:ATPremier MEM PLUS™垂直线焊解决方案与Asterion®-PW超声波针焊系统。这两项创新将重塑存储器与功率半导体封装技术,助力边缘AI、高算力芯片及新能源市场的快速发展。
尤其是HBM,由于美国实施了HBM出口禁令,因此本土HBM突破势在必行!库力索法的设备将有助于加速HBM的研发和产业化,缩小与国际巨头的差距。

库力索法执行副总裁兼总经理张赞彬( Chan Pin Chong)在媒体发布会上上表示中国大陆是Wire Bond的主流市场,也是库力索法非常重视的市场。目前Wire Bond在大陆是主流封装方案,不过这几年也会慢慢有其他先进封装方案在不断开发中。
“今年最特殊的是AI的发展。我们FTC(Fluxless Thermal Compression Bonding(无焊剂热压键合)是一种先进的芯片封装技术,主要用于解决传统焊接技术中的一些问题,特别是在高密度互连和精密封装领域。)有单头、双头,刚刚发布了第一台双头设备,目前在代工厂做测试和验证。用同样的设备,我们可以做铜与铜的结合。我们的想法是Hybrid Bonding可能时间还要过几年才成为主流,我们用传统的TC方法(铜与铜的结合),性价比有很大的优势。我们也在不断地开发铜与铜的结合,用TCB解决方案做到10微米以下的密度。”他强调,“随着 AI 芯片尺寸的不断增大,芯片利用率仍然存在优化空间,因此市场正逐步从传统的圆形晶圆(wafer)转向更大的方形 panel。目前的市场策略是从 310×310mm 发展到 600×600mm,这一趋势是为了满足 AI 发展带来的更大封装需求。当前,市场上芯片尺寸已达到 100×100mm 甚至更大,因此 panel 的尺寸升级也成为必要方向。针对这个趋势,TC Bonding技术有一些关键优势:一是Fluxless;二是超高密度封装,间距可达到10微米以下;三是铜-铜结合,适配更大 panel size。”
他表示TC Bonding 是市场上最热门的技术,TC Bonding的TAM(总可用市场)目前约为3亿美金,增长率在20%-25%之间。除了逻辑大芯片,几乎每一步都需要TC Bonding。相比于逻辑芯片(通常为单颗封装),HBM(高带宽存储)可能涉及 8 层、12 层甚至 16 层 以上的堆叠,因此在 HBM 领域,TC Bonding 的需求量预计会远超逻辑芯片,市场规模也将进一步扩大。
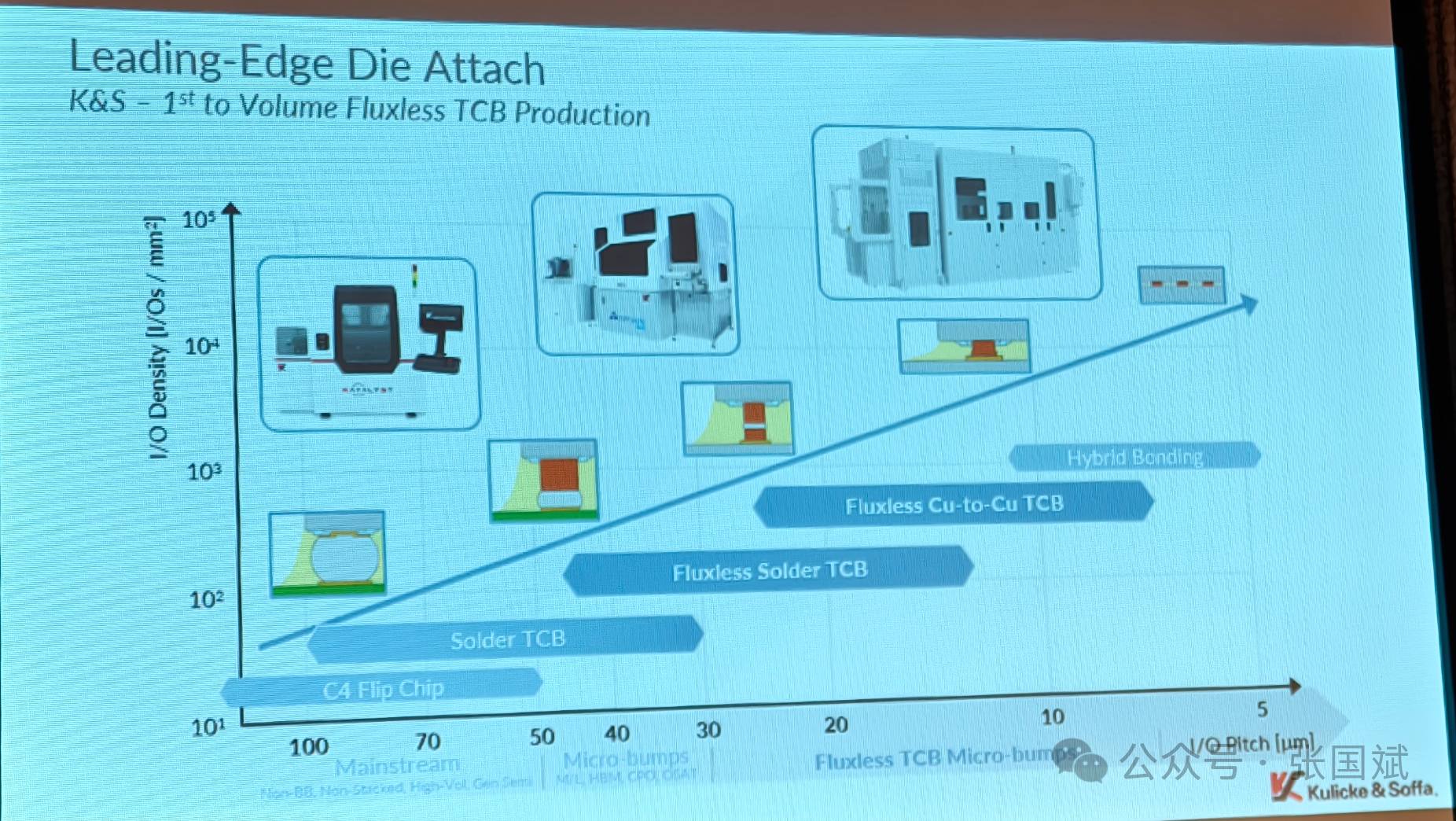
“TC Bonding为什么会有这么大的需求?比如密度从100微米到5微米,我们传统的打线封装可能往左,而Flip-chip倒装封装是从100微米到70微米,若要实现50微米以下的封装间距,就需要TC Bonding。我们的产品路线图也在不断优化。目前我们在把路线图往右边移,通过右移,我们的精密度可以达到10微米以下,我觉得这个设备的性价比Hybrid Bonding有很多实在的优势。10微米以下你就可以把Hybrid Bonding往后移,因为Hybrid Bonding是大投资,除了设备,整个制程方面都是很大的变化,尤其是代工厂对这种大变化的接受力会慢一点。”他补充说。
ATPremier MEM PLUS™:突破存储封装密度极限

库力索法球焊机事业部资深产品经理范凯介绍了新发布的ATPremier MEM PLUS™垂直线焊解决方案(如下图所示在SEMICON China有展示),他表示这款设备针对晶圆级存储器件,可以提供球焊和线焊技术方案平台。“如大家所见,设备外形体积非常小巧,这台设备也是目前晶圆级球焊、线焊速度效能最快,性价比最好的方案。”他指出,“目前设备可以提供三个主体模块制程:传统线焊键合方案支持、垂直线应用、球焊倒装焊工艺支持。这套设备会带来全新的结果导向工艺,有点像现在最新智能化自我学习模块化功能套件。另外设备硬件方面,我们也做了拓展,有更好的视觉系统。针对晶圆体迭代、叠层芯片结构,视觉系统要针对每一层不同芯片去更清晰地识别焊接位置,需要镜头的拓展。针对影像系统,我们也会提供像配套监控检查类的功能。设备主体可以支持8寸及12寸晶圆的应用,设备可以做晶圆级的互联配套方案。”

他详细了该设备的智能结果导向工艺套件,智能工艺套件针对第一焊点的球焊,库力索法有括ProVertical和ProCascade Loop可满足垂直线焊和阶梯线焊的精密互联要求,从而确保存储器应用的最佳性能。针对优化类的工具,如存储类器件,有一些芯片结构有悬空(Overhang)的结构,所以库力索法也有悬空方式做芯片形变探测,针对形变量有自我学习和优化工艺的工具。
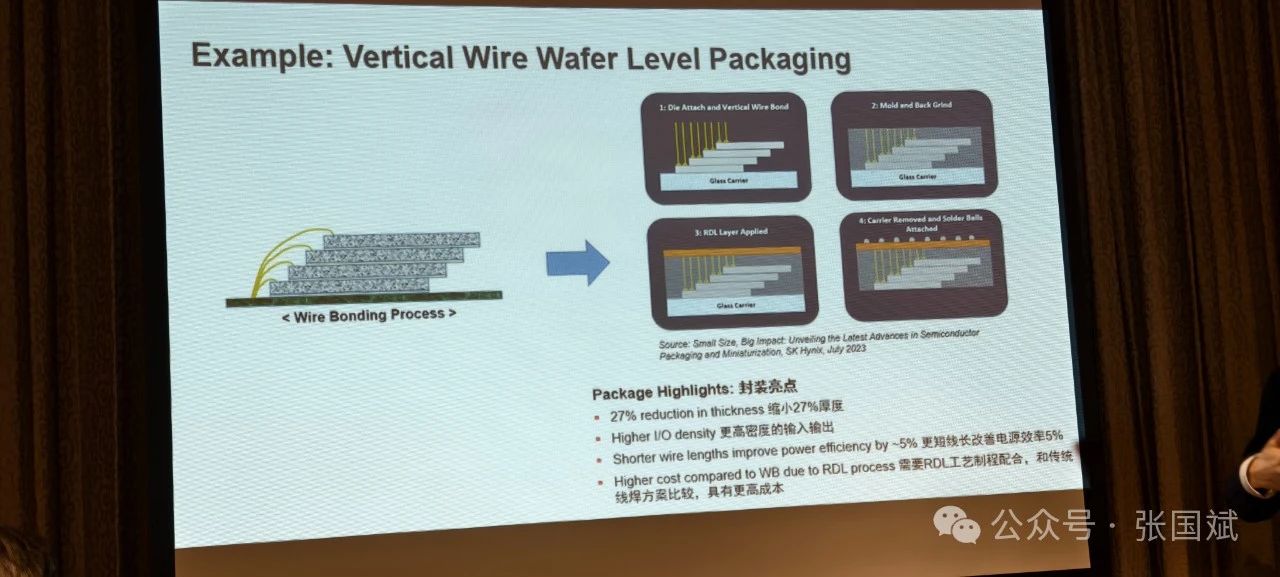
“叠层芯片需要可变焦镜头伸缩的配套能力,我们提供可变焦视觉系统,可伸缩跨度可达900微米。这款解决方案提供相对应工艺制程类监控功能,比如垂直线尖端,我们对形状、线头状态要有监测。通过影像系统,对线弧的弧高有检测,针对球焊的球的位置大小、焊接精度是否有工艺问题,我们也会提供相应的监测。另外是对位的十字线,本解决方案可以在焊接过程中检测对位精度,发现问题可以自动纠偏。”他介绍说,“目前行业内较流行的封装工艺结构。左边图片是传统存储类叠层芯片封装,底层采用PCB基板,芯片一层一层堆叠,并通过传统方式键合。而最新的晶圆级或面板级封装,则是先在玻璃面板上叠层芯片,并布设垂直线焊点。焊接完成后,进行塑封、研磨、RDL重新布线,最终去除玻璃面板,再通过Solar Bond互联工艺,完成封装。整体来讲,这就是最新的封装结构形式。通过垂直线做叠层芯片互联方式的形式,这个方式有什么好处和优势?相比于传统封装,器件尺寸厚度可以减少27%,由于它是晶圆级,我们可以做得更紧凑,在高密度布线可以做得更紧致。器件整体尺寸比较薄、比较小,整体工作能耗消耗就会减少5%。”
他表示面对边缘AI驱动下存储器市场25%的年复合增长率,传统晶体管微缩技术已难以满足高密度、低成本需求。ATPremier MEM PLUS™通过独家垂直线焊技术,将DRAM与NAND封装密度提升至全新高度,解决高容量存储器的核心挑战。
“存储类芯片的需求正在快速增长,叠层越来越多,密度越来越紧致。垂直线方案就提供了技术方向,可以通过这种互联方式在新型技术轨道上面实现目标。大家可以看到线焊的图片和焊针,都是针对这一类应用的结果和配套方向。大家可以看到图片中的焊针的侧面切掉一半,为什么会切掉一半?这是为了应对焊接间距缩小的需求。随着垂直线要求增加,焊接间距越来越小。另外刚才有展示垂直线,为了支持叠层芯片,可能很厚,需要垂直线的高度就很高。垂直线很高的话,不同线间距之间如果焊接很大就会产生干扰。我们做侧向切掉一半的特制化焊针,可以让线焊间距缩短到很小,再配合垂直线工艺,可以把线做得非常直,线尾也控制得非常一致,可以达到更优的配套互联方案。在线的垂直度、间距,包括实际作业效能方面,这款解决方案在晶圆级配套产品上可以为客户提供最大的产出。”他解释说。
范凯表示K&S的ProVertical和ProCascade Loop等先进工艺能力非常适合新兴的存储器应用,也可在存储以外的高容积需求的半导体市场实现更高密度封装。
ATPremer平台旨在服务高端封装市场,通过消除二维封装的限制,提供传统铜柱互联技术的替代方案。这种新颖的技术能支持下一代存储设备,包括消费类移动设备,因此能够平替性的实现高密度先进封装。ATPremier有效降低了封装的复杂性和成本,从而满足了高容积半导体市场不断增加的需求。
ATPremier MEM PLUS™为存储元件提供先进的晶圆级封装能力,ATPremer平台旨在服务高端封装市场,通过消除二维封装的限制,提供传统铜柱互联技术的替代方案。这种新颖的技术能支持下一代存储设备,包括消费类移动设备,因此能够平替性的实现高密度先进封装。ATPremier有效降低了封装的复杂性和成本,从而满足了高容积半导体市场不断增加的需求, 使客户在竞争激烈的存储器市场保持领先地位。
Asterion®-PW——K&S为功率半导体应用提供的另一种革命性解决方案

库力索法陈兰兰楔焊机事业部资深产品经理介绍了公司新推出的Asterion®-PW,这种先进的解决方案为引脚互连能力设定了新的标准,重新定义了效率、精度和可靠性。
“这款设备有三个特点,首先,这款设备比目前市面上所有超声焊速度要快很多;其次,单纯焊接肯定需要很多辅助工艺,如捆绑一个送针系统。我们会集成散装送针系统。而要做到过程稳定可靠,需要高精度线性马达定位系统。除此以外,只靠精准运动是无法实现高精度的,还要有视觉、还要辅助它的制具,这个制具就是我们焊头的精度,目前可以实现±40µm@3σ高精度的重复放置,而目前传统工艺是正负200,普遍存在的process基本上都是在正负150左右。”她介绍说,“既要做到高可靠性,还有性价比。在这个制程中,我们没有运用辅助传统材料,但超声需要媒介传输,于是需要有焊头。在此情况下,焊头相当于是耗材,而耗材意味着客户持续使用的成本。对此,我们设计了long-life焊头,该寿命目前是市面上使用寿命最长的,从而降低客户整体使用成本与整个封装模块成本。”

据她介绍,Asterion-PW超声波针焊接机与传统工艺相比,除了在制程上的优点以外,得益于它是铜材的结合,不需要借助别的材料,就可在可靠性、传输和散热方面取得优势。因为它不会有挥发物,所以对环境的影响也很小。另外,这款解决方案可帮助整体降低使用成本,因为不需要持续材料。另一方面,设备灵活性会更好,因为它是以插针的形式,可以根据客户的料来走,因为库力索法支持深腔作业,所以整个模块设计上没有限定。

库力索法先进封装事业部产品经理赵华介绍了库力索法先进封装产品的最新进展和我们最新的技术。
他表示得益于AI芯片模块中增长,库力索法的Fluxless TCB接下来会在AI领域封装扮演很重要的角色。根据Yole报告,TCB设备市场份额将从2024年的1.36亿美金增长到2029年的2.7亿美金,年化增长率会达到14.7%。
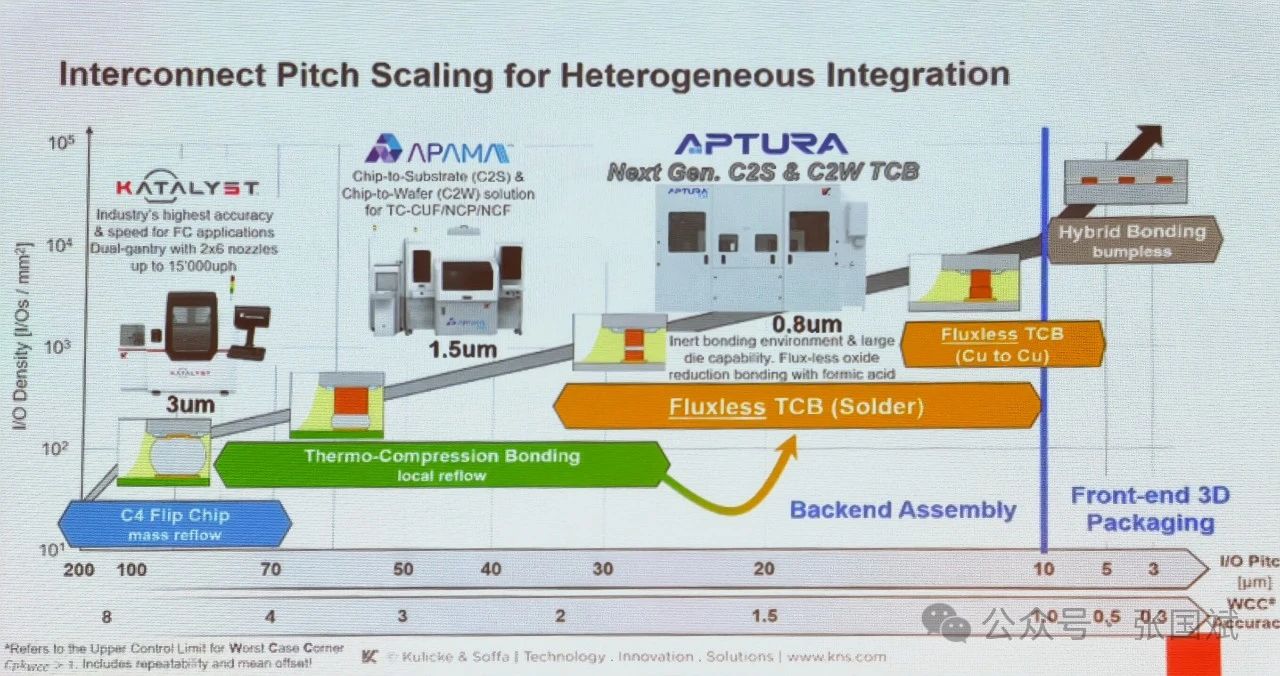
他表示针对除了TCB,库力索法针对于传统的Flip-chip和mass relfow,也有一个叫KATALYST的方案,KATALYST主要针对于像C4 Flip-chip bond和mass relfow工艺。这款解决方案主要针对于传统的bond pitch比较大的产品,bond pitch一般在在70-200微米这个范围之间。当bond pitch降到70微米以下时就需要用到TCB。

“我们从2014年就开始做TCB,第一代TCB叫APAMA,具备1.5um精度,支持像Chip-to-Substrate、Chip-to-Wafer不同进料方式,同时可以支持不同的工艺,像TC-CUF/NCP/NCF等不同的工艺。库力索法在2022年推出当时最新的TCB,我们叫做第三代TCB,即APTURA。这款解决方案在精度方面可以做到0.8微米,目前是业界依然是非常高的精度,仅次于Hybrid Bonding。另外,这款设备支持Fluxless TCB,同时这款设备也可以做铜对铜的Bonding。10微米往后可能大家比较了解的是Hybrid Bonding,我们现在在实验室做的甚至可以实现10微米以下的Hybrid Bonding。”他介绍说,“TCB有几个主要的应用方向,AP-HB-POP主要针对手机芯片工艺,手机中的CPU都是采用类似于AP-HB-POP工艺,或者直接把芯片贴到Substrate上面也是用TCB工艺,现在比较火的像AI&HPC,这个应用普遍来讲都是芯片尺寸会比较大。现在芯片尺寸可以做到70×70mm,我们也看到一些大厂正在研发更大的芯片尺寸。现在库力索法也在做90×120mm焊头,这也是为了符合主要客户未来的路线图。再就是大家也比较熟悉的HBM,这是属于高带宽存储的设备,目前是8层,接下来会做到12层甚至16层。”
库力索法为什么会研发Fluxless TCB?他解释说主要基于几点,当尺寸变得越来越大的时候,特别是die size大于50×50mm使用传统的Fluxless会遇到清洗不干净的问题。因为Fluxless都会在芯片中间,再用传统的Fluxless,就会存在清洗不干净的情况。
“当bond pitch小于45微米的时候,你可以看个芯片中间密度会越来越高时,也会存在助焊剂洗不干净情况。目前助焊剂清洗还没有标准检测来判定是否清洗干净,只能在后续可靠性测试中才会发现助焊剂有残留,所以这对于很多客户来讲是比较头疼的问题。像光通芯片,如特殊芯片,产品本身就不允许有任何污染。客户认为助焊剂可能存在污染,但如果使用我们的Fluxless就不会存在这样的问题。基于这几点,我们在比较早的时候就开始研发Fluxless。” 他举例说。
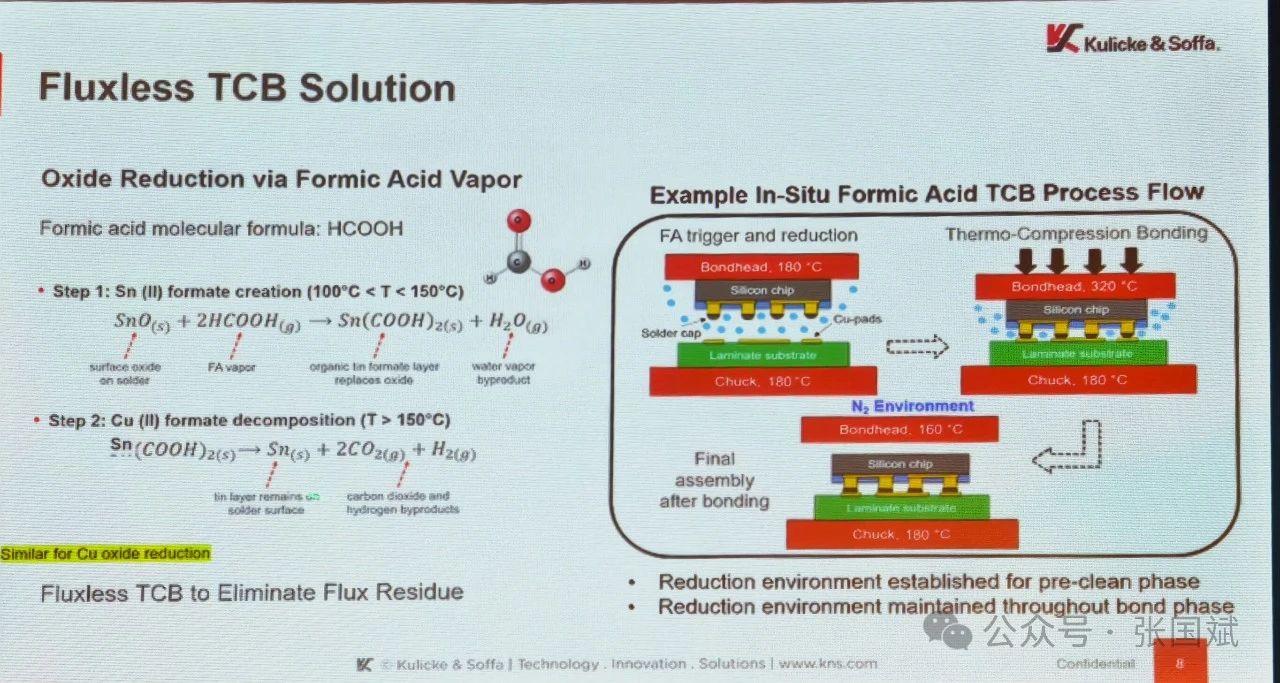
上图显示了库力索法Fluxless TCB解决方案,库力索法使用甲酸蒸汽去除锡或者铜表面的氧化物,这是甲酸还原氧化物的原理--当温度达到100-150度时,甲酸进去会与氧化锡发生反应,就会生成二甲酸锡和水。当温度大于150度时,二甲酸锡就会分解成锡、二氧化碳跟氢气,这也是化学的原理。甲酸回流炉已经非常成熟了,库力索法也是第一次将这个方案应用到TCB中的供应商。
据他介绍,库力索法Fluxless TCB有以下优势:
1、不需要使用助焊剂。直接通过设备提供的甲酸去除氧化物。不使用助焊剂也不会助焊剂的污染。其实助焊剂不只对产品产生污染,对设备和Bonding等其他敏感的元器件都会产生污染,而Fluxless TCB就不会存在这样的问题。
2、可以使用更高的加热温度。如果用助焊剂,会担心温度过高,助焊剂会挥发。而使用Fluxless TCB就不存在这种问题,可以使用更高的bond chip温度。另外,没有助焊剂,就不存在助焊剂针对机感或者芯片表面的遮挡问题。他表示库力索法的Fluxless TCB(甲酸方案TCB)最少有2家开始量产,此外,Fluxless TCB也通过了CE、CEMI S2方面的认证。即使在24小时量产的情况下,它也满足这些标准,是业界领先的方案。

他表示Fluxless TCB除了做传统的solder Bonding,还可以用于Cu-Cu方案。“大家讲到Cu-Cu,首先会想到Hybrid Bonding,其实Hybrid Bonding有它一定的优势。我们现在研发的Fluxless用于Cu-Cu方案,也有很多可行之处。Cu-Cu Bonding如果用TCB方案来做需要两个条件,第一个in-situ Reducing Gas,需要持续化氧化的过程,可以在整个过程中持续供给甲酸,这样可以持续去氧化物。哪怕在高温情况下,铜稍微有一些氧化物,也可以持续进行去氧化。”他解释说,“ 第二个就是惰气的环境,我们产品具备氮气腔,整个Bonding都是在密闭的氮气腔实现的。这个氮气腔里面的氧含量可以达到50个PPM以下,这也是针对铜对铜TCB非常关键的因素之一。Cu-CU Bonding有什么好处?它可以使bond pitch做到更小,像Hybrid Bonding降到10微米以下。我们这个方案也可以降到10微米以下。如果使用传统方式会产生金属间化合物(Intermetallic Compound,简称IMC)的问题。Bond的直径越来越小时,IMC对产品的影响会越来越大。Cu-CU Bonding就不会存在IMC的问题,这也提高了其可靠性。”
他还将Hybrid Bonding与Fluxless TCB做了对比。
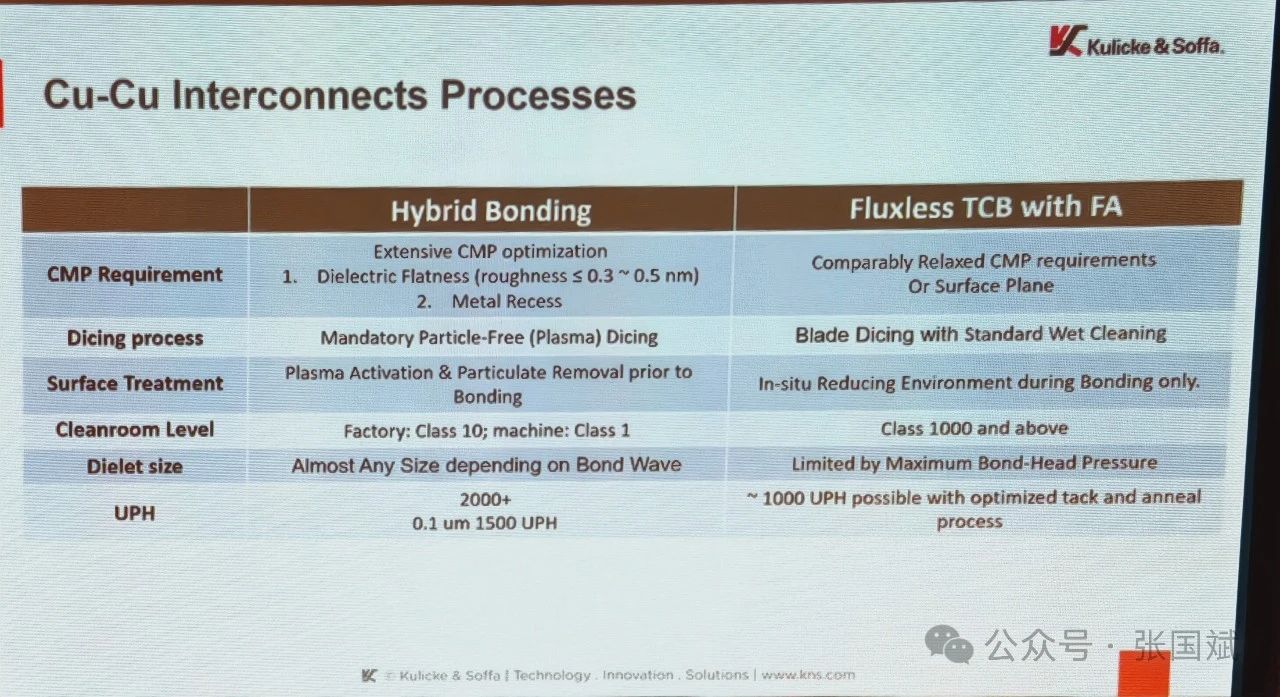
首先是CMP,Hybrid Bonding对CMP要求非常高。CMP甚至要求达到0.3-0.5个纳米。实际上,Fluxless TCB做Cu-CU Bonding并没有要求这么高的Bonding,因为库力索法有source,有heater去加热,只要CMP达到3纳米左右就可以。
第二个就是Dicing,Hybrid Bonding必须要求用Plasma切割,因为Plasma可以更好控制particle的产生。而库力索法要求没有这么高,只要用传统刀切以及标准水洗就可以。在洁净度方面,Hybrid Bonding甚至工厂要求达到Class10,机器要达到Class1,相当于是晶圆厂的标准;而库力索法只需要在千级的环境就可以,传统封装厂就能达到这个要求,所以不需要进行高额投资做无尘环境。
“Fluxless TCB在做Cu-CU Bonding过程当中有一定优势,当然也会有一些缺点。从UPH方面来讲,Hybrid Bonding可以做到2000+的UPH。目前我们通过Tack+anneal的方式可以做到1000UPH,还会进一步改良工艺。”他坦承。
“APTURA是第三代TCB,是目前唯一一家将Fluxless TCB用于量产的设备。这台设备满足大部分客户的需求。针对现在芯片越来越大,bond pitch越来越小,我们都是能支持的。针对不同的客户,我们提供large die size的选择,目前能做到最大的Die size70×70微米,未来会开发90×120。这台设备精度也可以达到0.8微米30XY。”他介绍说,“该设备具备惰性气体,氧含量可以达到100ppm以下,可以支持不同source的input,像Wafer frame T&R Tray,目前这款设备是面向未来的高端产品。”
张赞彬指出中国市场充满了机遇,因此库力索法不同领域的设备都有很好的发展前景。超声波针焊接机的应用领域是能源和电动汽车,而在先进封装和存储领域库力索法有TCB,每个领域都有自己的发展路径,需求旺盛。(完)
注:本文为原创文章,未经作者授权严禁转载或部分摘录切割使用,否则我们将保留侵权追诉的权利
